오늘은 이온 주입 및 확산 공정 (Ion Implantation & Diffusion)에 대해 알아보겠습니다.
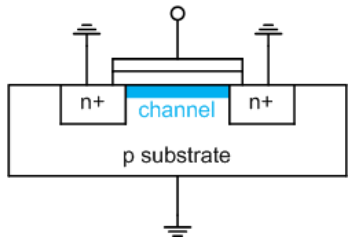
MOSFET을 보면 이온의 농도가 다르게 분포해있습니다.
전압을 걸어주면 전자와 정공이 이동하면서 채널이 형성되고
이 채널을 통해 전류가 흐르면서 on/off가 결정됩니다.
따라서 이온 주입은 필수라고 할 수 있는데요
이온을 어떻게 넣어주는 지 공부해보도록 하겠습니다.
확산 공정에서의 조건
CDS (Constant Source Diffusion): 단위 면적 당 불순물 수 = 농도 = Dose량
LSD(Limited Source Diffusion): 공정이 진행되는 동안 Dose량이 일정해야 됨
이온 주입 및 확산 단계
먼저 pre-deposition 단계에서 이온을 얇게 주입 시킨 후 Drive-in 시킵니다.
이온을 주입할 때는 우선 sreen oxide를 형성 하고 Ar 등을 쏴서 표면을 망가뜨려줍니다.
그러면 Si 표면이 비정질이 되면서 channeling effect가 발생할 확률이 줄어듭니다.
그 후 실제 이온을 주입할 차례인데 이때 7'정도 tilting하여 쏘아줍니다.
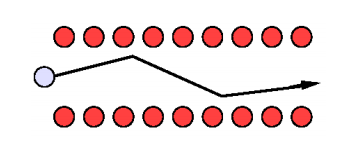
이 방식 역시 channeling effect를 방지하기 위함입니다.
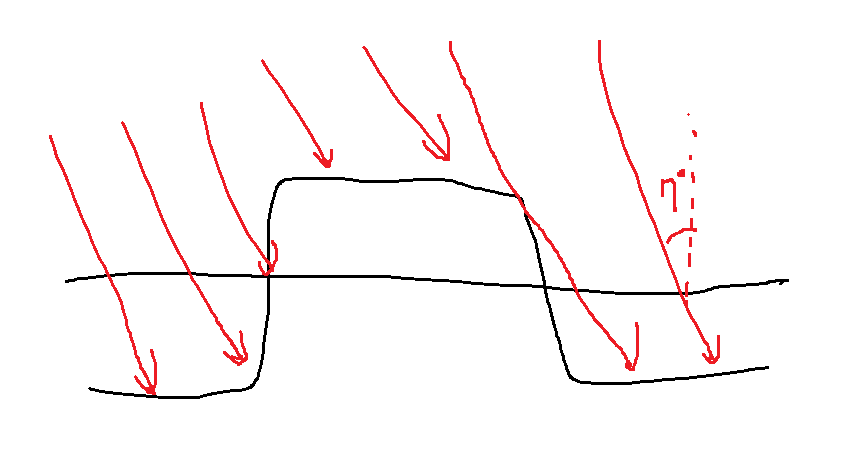
문제는 이렇게 tilting하여 쏴주었을 때 닿지 않는 Shadow가 생길 수 밖에 없겠죠?
이 문제를 해결하기 위해 여러 방향에서 이온의 농도를 나눠서 여러번 쏴줍니다.
pre-deposition 단계가 끝나면 이온을 깊게 퍼뜨려야 합니다.
이를 Annealing이라고 하는데요,
몇 가지 방법을 이용해 이온을 drive-in 시켜줍니다.
Furnace
뜨거운 furnace에 몇 시간 동안 넣어두는 방식이 있습니다.
보통 Well을 형성할 때 사용합니다.
RTA (Rapid Thermal Anneal)
Furnace와 다르게 5초 정도만 가열합니다.
열을 가하면 데미지가 회복되고 내부 defect가 빠르게 없어집니다.
표면 defect의 경우는 어차피 cleaning할거라 크게 상관 없습니다.
Laser Annealing
위 두가지와는 다르게 원하는 부분만 빠르게 가열하는 차세대 기술입니다.
1ms도 안되는 시간 내에 온도를 빠르게 올릴 수 있습니다.
'반도체공정' 카테고리의 다른 글
| [반도체공정] 증착공정 (Deposition) (1) | 2023.01.27 |
|---|---|
| [반도체공정] 식각공정 (Etching) (1) | 2023.01.14 |
| [반도체공정] 사진공정 (Photo Lithography) (1) | 2023.01.14 |
| [반도체공정] 산화공정 (Oxidation) (1) | 2023.01.14 |
| [반도체공정] 웨이퍼 제조 (1) | 2023.01.14 |




댓글