식각 공정 (Etching) 입니다.
말 그대로 물질을 깎아내는 것입니다.
식각이 잘 되고 있는지는 여러 비율을 통해 알아 볼 수 있습니다.
식각 속도 (Etch Rate)
[ 식각된 두께 ] / [ 식각 시간 ] 으로 나타내며 빠를수록 선호하는 경향이 있습니다.
선택비 (Selectivity)
[ Target의 식각 속도 ] / [ Mask, Material의 식각 속도] 로 나타내며 클수록 Etching 이 잘 된다는 뜻입니다.
Critical Dimention
포토, 식각 후 가장 작은 패턴의 size를 나타냅니다.
등방성 (Isotropic) vs 비등방석 (Anisotropic)
이건 사진으로 보는 것이 이해하기 쉽습니다.

Isotropic은 모든 방향으로 비슷하게 Etching 되었다는 뜻으로 수직으로 깎이지 않아 이후에 문제가 될 수 있습니다.
반면, Anisotropic은 특정 방향으로 식각이 진행됩니다.
균일도 (Uniformity)
Center와 Edge 등 웨이퍼 상의 여러 부분에서 etch rate의 차이가 있을 수 있습니다.
균일할수록 이후 과정에서 오차가 발생하지 않습니다.
Concave ∪, convex ⌒

Center와 Edge의 Uniformity를 살펴보면 위와 같이 concave 또는 convex한 형태로 나타날 수 있습니다.
Uniformity를 개선하기 위해선 플라즈마 분포도, gas 분포도 등을 균일하게 맞춰야 합니다.
습식 식각 (Wet Etching)
습식 식각은 화학적으로 이루어집니다.
장점으로는 저비용, 쉬움, Etch rate가 높음(빠름), Selectivity가 높음 등이 있습니다.
단점으로는 정확성이 떨어지고 웨이퍼 오염이 있고 컨트롤이 어렵다는 점이 있습니다.
또한 20nm이하는 어려운데 이유는 Isotropic해서 PR의 under cut이 발생하기 때문입니다.
밀도가 높을수록 etch rate가 낮은 특징이 있습니다.
전체적으로 식각이 필요한 경우 사용합니다. 예시로는 Cleaning이 있습니다.
SiO2는 NH4F : HF = 6:1 비율로 클리닝을 하고
Si는 HF + HNO3를 사용합니다.
건식 식각 (Dry Etching)
건식 식각을 하면 밑으로 쭉 파고들면서 깎아내기 때문에 종말점 (EOP)를 찾는 것이 중요합니다.
Over Etch와 Under Etch를 방지하기 위함입니다.
건식 식각 종류
High Pressure Placma Etching (ICP)

화학적으로 식각합니다.
높은 Setectivity를 갖지만 Isotropic하고 Etch Rate가 낮습니다.
Feed gas가 chamber 안에서 plasma에 의해 Chemically reactive (Radical)한 상태가 됩니다.
이후 확산되어 웨이퍼 표면에 흡착합니다.
표면에서 확산하며 반응을 한 후 탈착하여 확산되며 밖으로 빠집니다.
Ion Bombardment
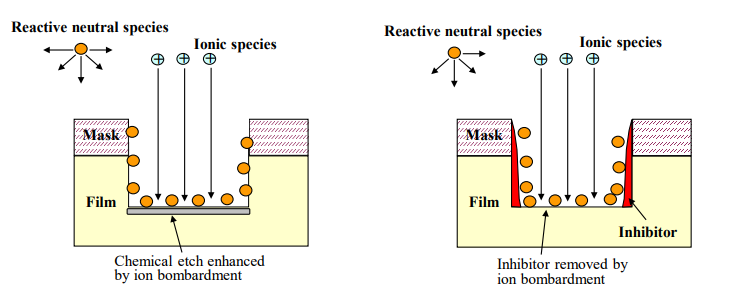
물리적으로 식각합니다.
Anisotropic하지만 Etch Rate가 낮고 Selectivity가 낮으며 Throughput이 낮습니다.
Ar gar를 주입 후 가열하면 전자가 튀어나와 양극으로 가속됩니다.
이후 Ar과 충돌하여 이온화가 되는데
이때 생성된 Ar+가 웨이터 표면을 때리면서 식각합니다. (sputtering etching)
RIE (Reactive Ion Etching)

물리적 + 화학적 방식입니다.
위의 두 가지 방식을 합친 것으로 Anisotropic하며 Etch Rate가 높고 Selectivity 역시 높습니다.
Ar+가 표면을 때려서 느슨해지면 Radical이 화학 반응을 일으켜 날려버리는 구조입니다.
ALE (Atomic Layer Etching)
원자층을 한 층 한 층 쌓아 올리는 ALD와 반대로,
원자층을 한 층씩 깎아 내는 차세대 기술입니다.
Plasma 발생 원리
CCP (Capacitive Coupling Plasma)
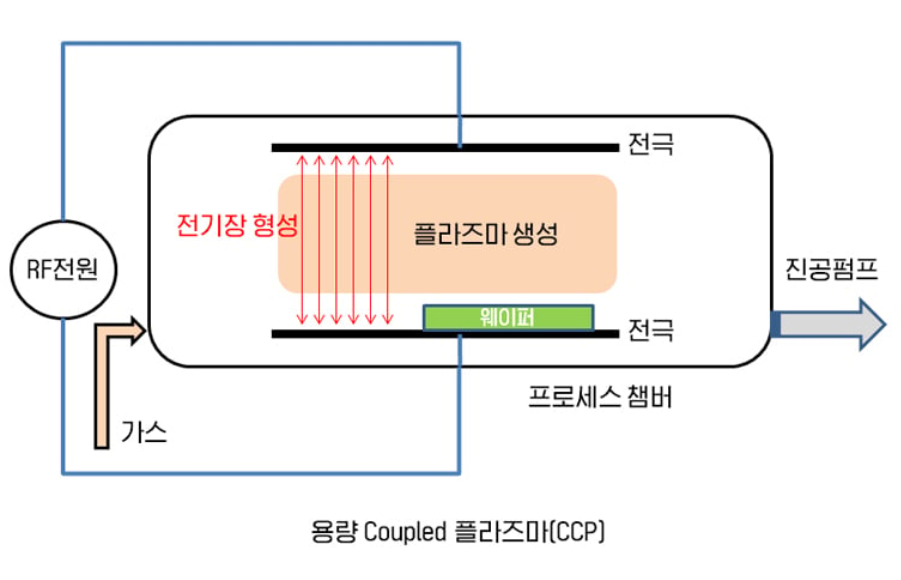
밀도가 낮지만 균일도가 높습니다.
평행판 전극 사이에 RF of DC 전극을 걸어 내부에 Plasma를 발생시킵니다.
ICP (Inductive Coupling Plasma)

밀도가 높지만 균일도가 낮습니다.
챔버 밖 코일에 의한 유도전기장으로 Plasma를 발생시킵니다.
ECR (Electron Cyclotron Resonance)
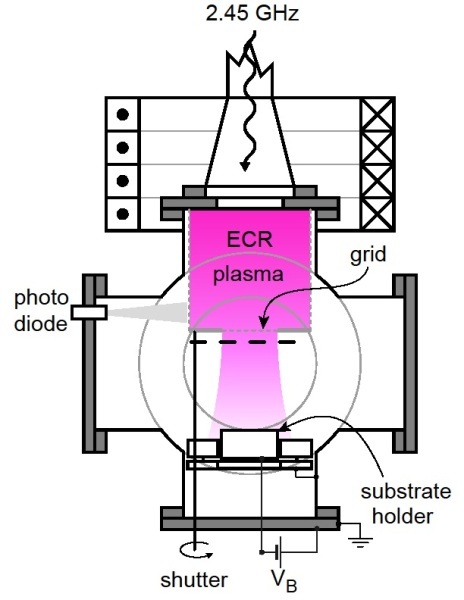
원운동하는 전자가 회전 주파수와 일치하는 microwave와 공명 가속하여 Plasma를 발생시킵니다.
'반도체공정' 카테고리의 다른 글
| [반도체공정] 증착공정 (Deposition) (1) | 2023.01.27 |
|---|---|
| [반도체공정] 이온주입 및 확산공정 (Ion Implantation&Diffusion) (1) | 2023.01.17 |
| [반도체공정] 사진공정 (Photo Lithography) (1) | 2023.01.14 |
| [반도체공정] 산화공정 (Oxidation) (1) | 2023.01.14 |
| [반도체공정] 웨이퍼 제조 (1) | 2023.01.14 |




댓글